はじめに
前回はAlGaN/GaN Ridge HEMT(GIT-HEMT)のドレイン電流モデルを中心に,ドレイン・ソース抵抗のモデルも考察しました.
今回はRidge HEMT特有のホール注入による過剰電流解析と,モデル化について考えてみたいと思います.
ホール注入による電流 [1]
第13回で解説しました,Ridge HEMTの特徴であるホール注入による過剰電流についてモデル化してみます.再度簡易的なデバイス構造を図1に示します.
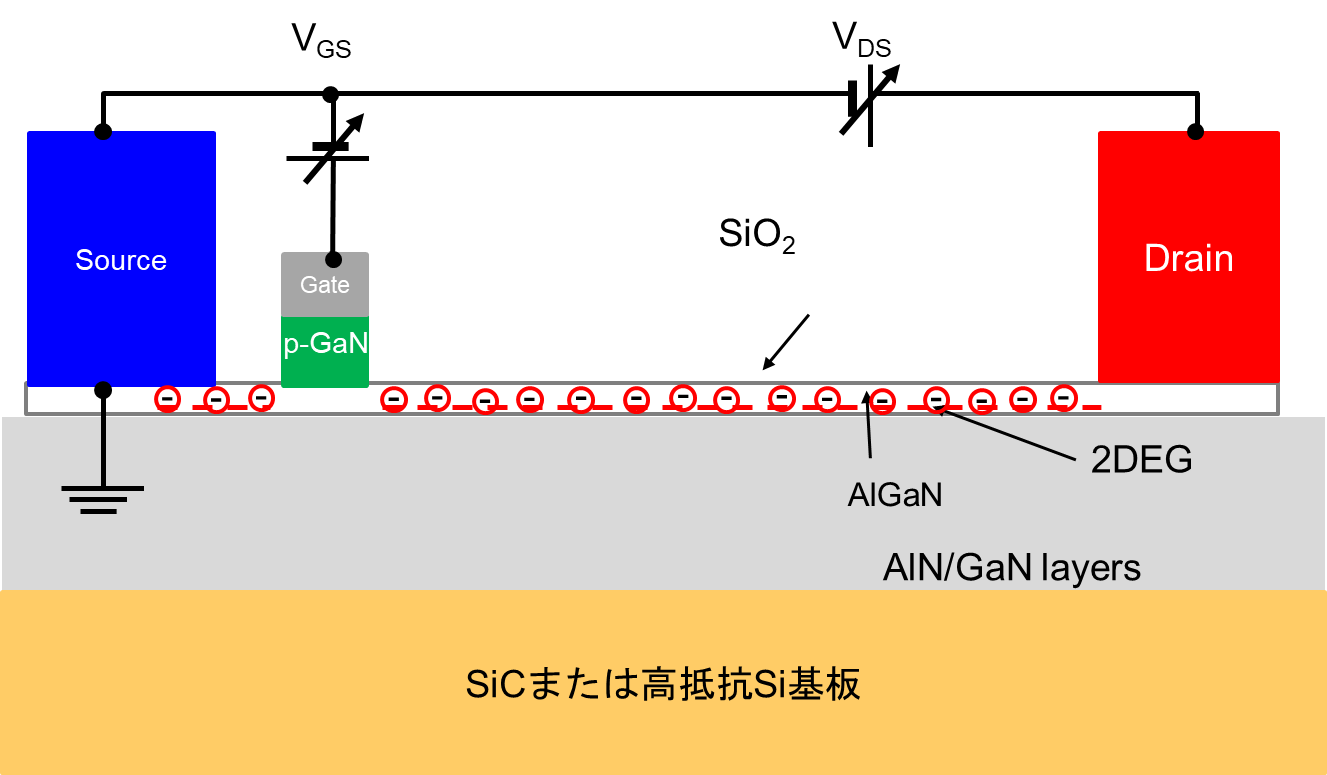
図1.Ridge HEMTのデバイス構造(ここでVGSとVDSにはバイアスを印加していません)
ゲート,ドレイン電圧が0Vの時は,図1に示したように,ゲート直下のチャネルが空乏化してゲートにチャネルが形成されないため,ドレイン電流は流れません.
次にバイアスを印加した場合のRidge HEMT動作を,図2を参照しながらバイアス状態ごとに解析していきます.
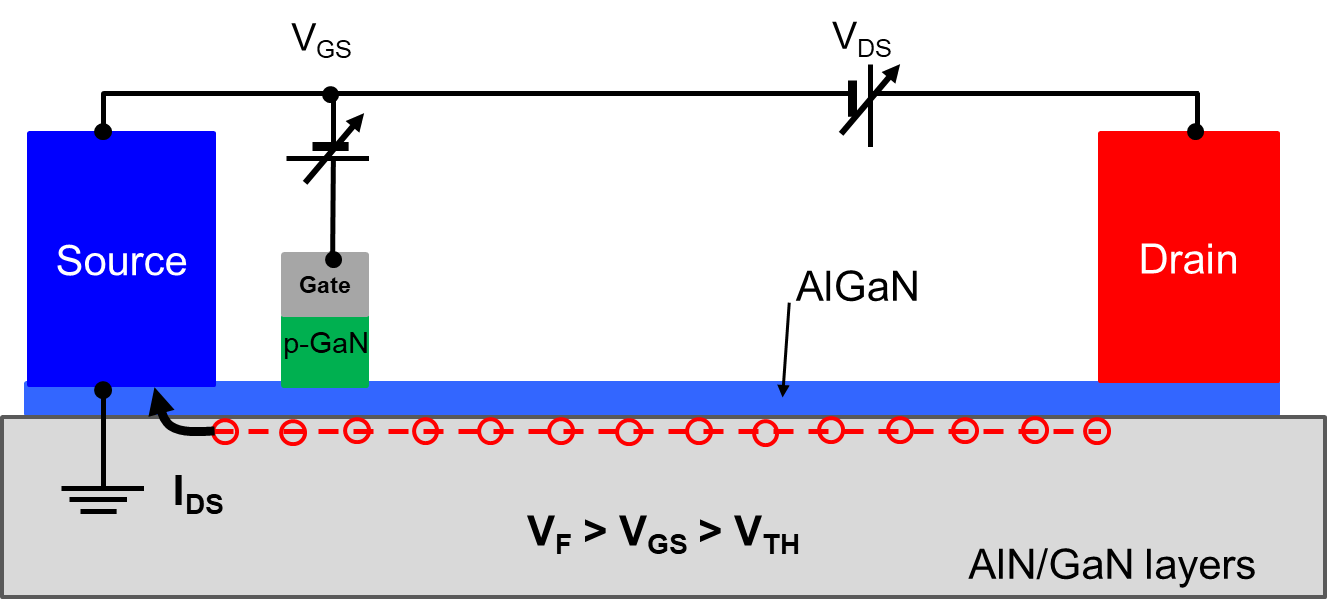
(a)
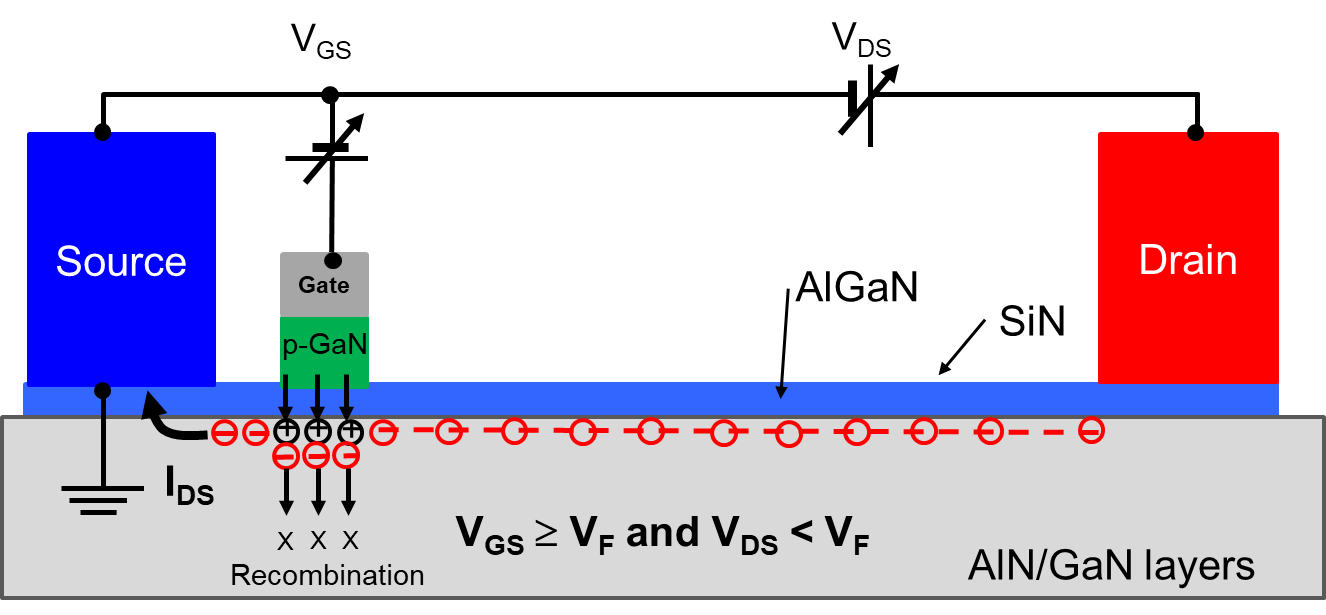
(b)
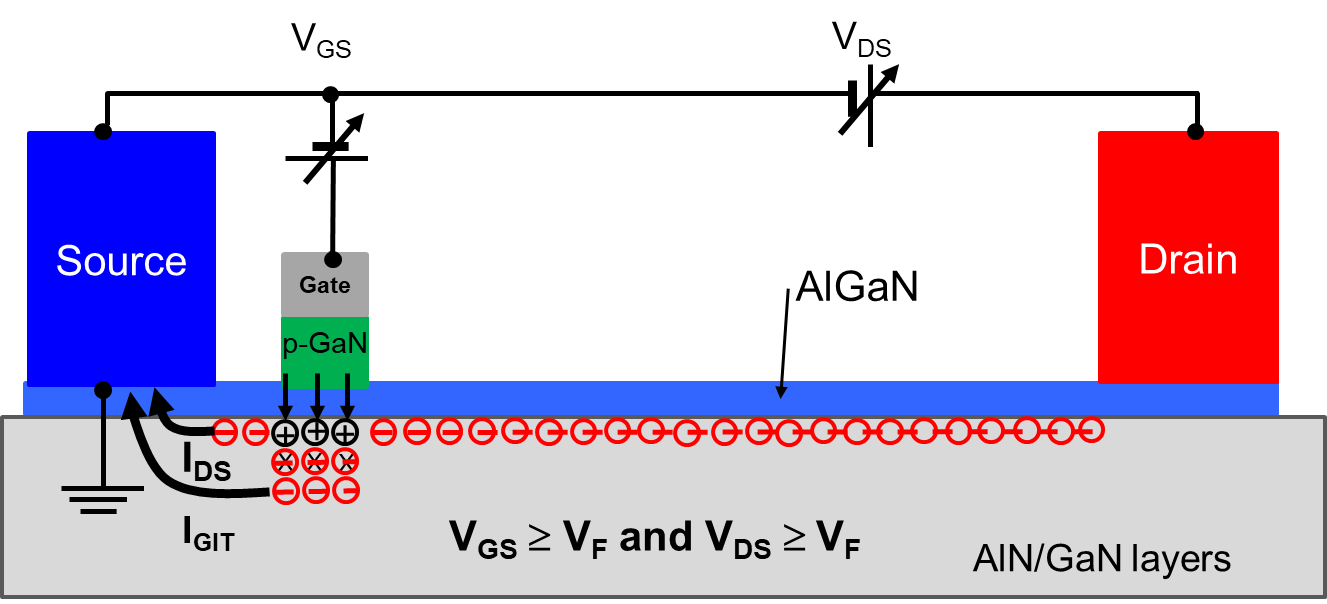
(c)
図2.ゲート電圧によるRidge HEMTの動作.(a) VF > VGS > VTHの場合 (b) VGS > VFでVDS < VFの場合 (c) VGS > VFでVDS ≧ VFの場合
図2(a)のようにゲート電圧が正で,pn接合の順方向ビルトイン電圧VFより小さい場合には,チャネルのポテンシャルが下がりチャネルに電子が発生するので,通常のFETと同様の動作をします.このドレイン電流をIFETとすると,
 (1)
(1)
全ドレイン電流(IDS)は,
 (2)
(2)
となります(第15回で言及).
図2(b)の状態では第13回で解説したように,ゲート電圧がVF以上になるとゲートからチャネルにホールが注入され始めます.電子はヘテロ接合のポテンシャル障壁によりゲートには流入しません.チャネル内には電荷の中性条件のため,注入されたホールと同量の電子がソースから移動します.発生した電子は,ドレイン電圧によってドレインに向かって移動します.一方ホールは電子より移動度が数百分の一であるので,ソース側に少々移動するがゲート近傍に停滞します.電荷の中性条件を満たすために,注入されたホールと同量の電子をさらに発生させることになり,注入されたホール数と発生した電子数の比はほぼ等しくなります.しかし,ドレイン電圧がVFより低い場合には,増加した電子がゲート近傍に停滞しているホールと結合するので,その分ドレイン電流が急激に増加することはありません.
つまり,ここでも式(2)となってFET動作します.
さて,図2(c)のように,ドレイン電圧がVFより高い場合には,さらに余分の電子がソースから注入されるためにドレイン電流は急激に増加し,過剰電流(ここではIGITと呼ぶ)が発生します.このIGITは当然無限に増え続けることはなく,最大過剰電流(IGIT0)に制限されます.方程式は以下のように考えられます.
 (3)
(3)
ここでXλ ホール注入による最大電流の係数です. 一部のソースから発生する電子はゲート直下に停滞しているホールと結合するため,過剰電子が蓄積される領域は とNGFに依存します.
とNGFに依存します.
図2(a), (b), (c)を条件別にモデル式を記述していくと,不連続点が発生してシミュレータが収束しません.そこで,統合したモデル式をBoltzmann関数により記述すると以下のようになります.
 (4)
(4)
ここでVEXホール注入による電流のオフからオンへの遷移ゲート電圧を示します.遷移電圧はシングルフィンガーゲートより,マルチフィンガーの方が大きくなるのでVEXはNGF倍されています.
全ドレイン電流は,
 (5)
(5)
と表せます.
ドレイン電流のシミュレーション [2]
実際にホール注入による過剰電流特性を確認するには,飽和領域のドレイン電流・ゲート電圧特性を測定します.過剰電流の発生点を確認するために,伝達コンダクタンスGmに変換して解析します.
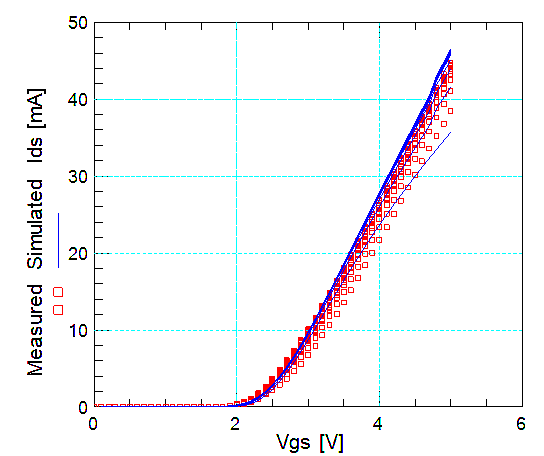
(a)
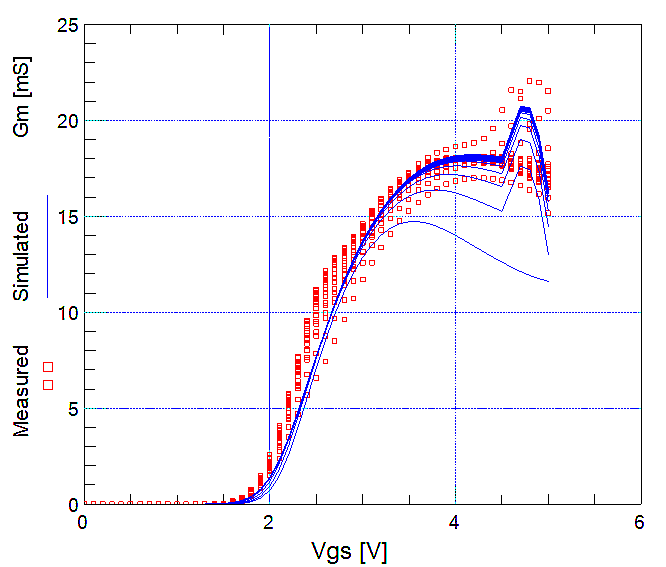
(b)
図3 Ridge HEMTの飽和領域Ids-Vgs特性の測定とシミュレーション.(a) Ids-Vgs (b) Gm-Vgs(Vgsは 4 Vから40 Vに2 Vステップ)
図3(a)の破線で囲んだ部分を注意深く観察すると,電流特性の急激な増加点がなんとか確認できます.これをGm特性で観察すると,図3(b)のようにピーク点が現れます.作成したモデル式によるシミュレーションは,測定データに近似していることがわかります.ただ,ここで抽出したモデルパラメータは,チューニングを完全に行っていないため,Vgsが低い領域で合致していません.
今回は割愛しましたが,ゲートチャネル長・幅や,フィンガー数,トランジスタユニット数にもスケーリングできているため,興味のある方は文献 [1]を参照してください.
まとめ
今回はRidge HEMT特有のホール注入による過剰電流解析とモデル化を言及しました.
次回は最後にRidge HEMTの高周波特性モデルについて,考えてみたいと思います.
参考文献
- H. Aoki, N. Kuroda, A. Yamaguchi, and K. Nakahara, “Temperature Characterizations of Multi-Unit and Multi-finger Dependencies on AlGaN/GaN Ridge HEMTs," 2022 IEEE 34th International Conference on Microelectronic Test Structures (ICMTS), (March 2022), Cleveland, OH, USA.
- H. Aoki, H. Sakairi, N. Kuroda, A. Yamaguchi, and K. Nakahara, “Drain Current Characteristics of Enhancement Mode GaN HEMTs,” 2020 35th Annual IEEE Applied Power Electronics Conference & Exposition (APEC 2020), (March 15-19, Online), New Orleans, Louisiana, U.S.A.
(株)モーデックでは,高度なVerilog-Aを含むコンパクトモデル開発,測定,パラメータ抽出システム開発などの実務以外に,IEEEをはじめとする学会の英文論文誌投稿,国際学会発表のための投稿論文作成のお手伝いなども行っております.
モデリングに関する様々なご依頼をお受けいたしております.いつでもお気軽に問い合わせください.
