はじめに
前回は,物理的モデルの一つとして,Advanced SPICE Model for HEMTs(ASM-HEMT)モデルを紹介しました.今回は,同じCMC推奨のもう一つのモデル,MIT Virtual Source GaN HEMT(MVSG)モデル [1]を取り上げます.
Virtual Sourceモデルについて
Massachusetts Institute of Technology (MIT)のAntoniadis教授研究グループは,以前よりシリコンベースのナノスケール・トランジスター(Silicon MOSFET)とIII-V族のHEMT用に,わずかな物理パラメータで準弾道トランジスタの物理を正確に記述する半経験的なモデルを開発してきました.
Virtual Sourceモデルの前提として,固有領域,アクセス領域,およびフィールドプレート領域は平均自由工程より十分に長いと想定されています.つまり,キャリア輸送がドリフトと拡散のみである前提です.したがって,これらの領域の暗黙のゲートモデルは本質的に非弾道チャネルです.以下に説明する式は一般的なものであり,様々なトランジスタに適用できます.
独自のパラメータを持つHEMTの場合,ゲートオーバードライブ電圧は,[2]に示されているようにシート抵抗に関連しています.残りの方程式は,従来の移動度劣化・飽和速度低減の輸送方程式です.これらの領域モデルで採用されているドリフト・拡散チャネルモデルの方程式を使用します.図1に示すようなバンドプロファイルを想定します.
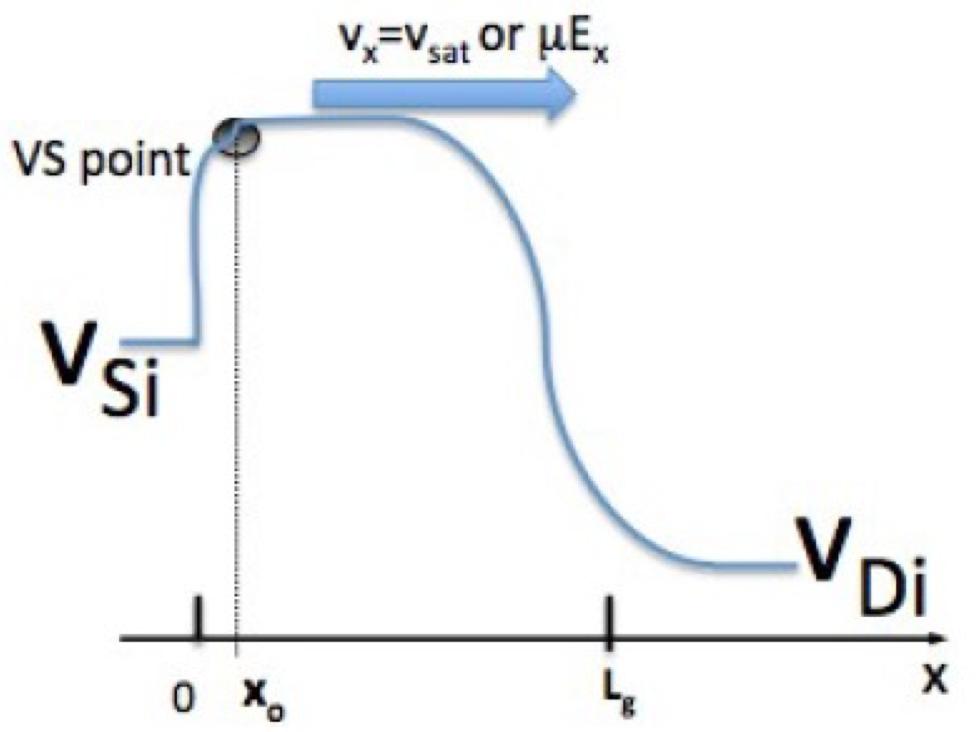
図1.ドレインバイアス下のドリフト・拡散チャネルトランジスタモデルで想定された
伝導帯プロファイル [1]
電流は,仮想ソース点(VSポイント)での電荷と速度の積によって与えられます(別の言い方をすると,チャネル内の任意のポイントで,電流は局所的な電荷と速度の積です)が,VSポイントでの電荷は[3]の(2)で与えられるものと同じであり,VSポイントでの速度は弾道のように単純な定数でバイアスに依存しない量ではなくなりました.長いチャネルでは,輸送はドリフト/拡散(DD)とチャネル内の任意のポイントでのキャリア速度は,ローカルフィールド( )に依存します.ドリフト電流の方程式は次の式で与えられます.

ここでψは位置xの電位です.
式(1)をもとに,各動作領域においての条件を定義して方程式を展開していくことで,VSモデルの電流式が求められます.詳細は[1]などを参照してください.
MVSGモデル
GaN HEMTの典型的なデバイス構造を図2(上)に示します.デバイス構造を図2(下)のマクロ等価回路に置き換えると,5つの異なるトランジスタに置き換えられます.電圧VsiとVdi端子を持っているのがコアのトランジスタで,詳細なモデリングが必要なデバイスです.その他は寄生的なコンポーネントとして固有のトランジスタ領域があります.一つは,2DEGがゲート電圧(VG)によって変調されるゲートで,耐圧を上げるフィールドプレート領域ゲート(MVSGは最大4つのフィールドプレートをサポート)です.もう一つは,2つのアクセス領域からなります.アクセス領域(ソースゲートとドレインゲート)は,非線形ゲート電圧依存抵抗として使用されるゲートトランジスタです.
MVSGモデルは,各サブサーキットのトランジスタは基本的に共通のアルゴリズムを用いており,入力する変数によって違った寄生コンポーネント動作を実現しています.Verilog-Aのソースプログラムでは,トランジスタ一つのサブルーチンに与える変数によって,5つのトランジスタ動作を計算していますので,効率良くできています.同時に,アクセス領域の複雑なバイアス依存のある抵抗であっても,自由度のある特性表現ができます.
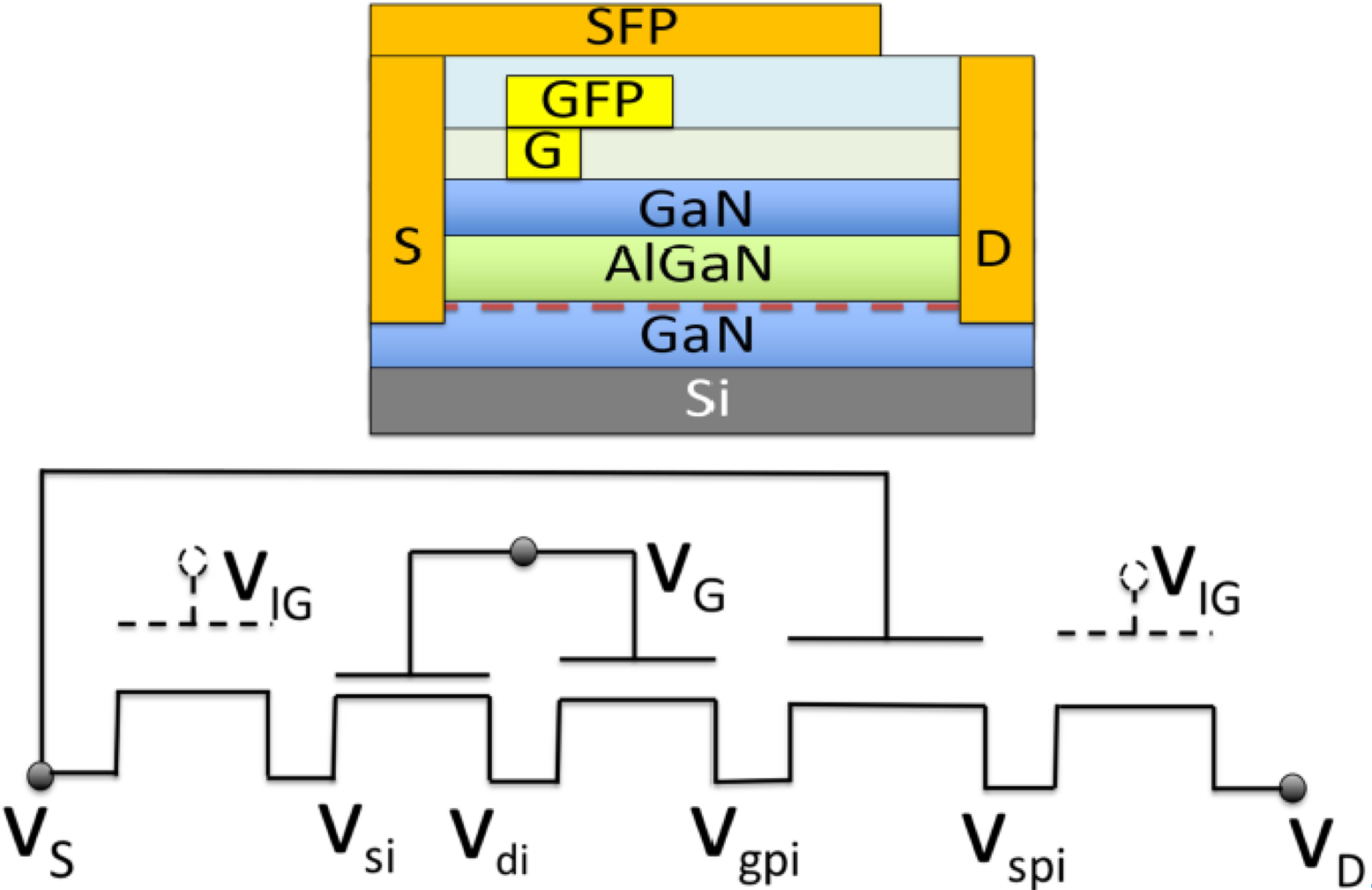
図2.上:シリコン基板GaN HEMTの構造断面 下:MVSGモデルのマクロ等価回路 [1]
例えば,2つのフィールドプレート(FP)トランジスタにおいて,ゲートが接続されたゲート・フィールドプレート(GFP)ゲート端子と,ゲートがソース端子に接続されているソース・フィールドプレート(SFP)は異なるしきい値電圧を持っていますが,このマクロ等価回路アプローチで簡単に対応できます.
MVSGモデルの特長
マニュアルに掲載されている特長としては,以下のようなものがあります.
- 正確なフィールドプレートのRF特性
- ゲートリーク電流特性
- デバイスノイズ特性
①NF特性
②位相雑音特性 - チャネルRFトランスコンダクタンス分散特性
- チャネル ブレークダウン特性
- 分散ゲート抵抗
測定データを用いてモデリングを実施してみると,そのデバイスのプロセスによってシミュレーション精度が違う場合が多いので,モデルの絶対的な性能を論じることは困難です.
そこで,静特性で重要なドレイン電流・電圧特性について,3つの全く違った環境,プロセス条件で作成されたAlGaN/GaN HEMTデバイスをモデリングした際のシミュレーション結果を見てみます.ここでは,プロセスパラメータなどデバイスの仕様,実測値は提示できませんので,シミュレーションデータについて,カーブの形状に着目してください.プロセス(a), (b), (c)すべて測定値とのRMS誤差は4%以内でモデリングできています.また,ここでは割愛しました,ドレイン電流・ゲート電圧特性,ゲート電流特性,など他のDC特性でも,同様な精度でモデリングできました.



図3.異なる3プロセス(a, b, c)のGaN HEMT抽出後のモデルパラメータを用いた
ドレイン電流・電圧特性シミュレーション結果
プロセス(a)のデバイスは,デバイスの構造上ピンチオフ点が現れずにバイアス依存抵抗特性のようになっていますが,MVSGモデルに使われている経験的な関数式部分の自由度によって,表現できています.プロセス(b)デバイスでは,自己発熱が起こっているために負性抵抗特性が現れていますが,MVSGモデルの自己発熱モデルによって表現できています.もちろん正確にはAC特性,パルスDC特性で矛盾なくシミュレーションできているか確認する必要があります.プロセス(c)デバイスは,理想的なFET特性に近いものですが,表現できています.モデリングにおいてピンチオフ部分のスムージングパラメータを最適化すれば,図3(c)のピンチオフ部分の角はなくなります.
この例のように,MVSGモデルは静特性において,物理的でありながら経験式による自由度が高いため,非常に実用度が高いモデルと考えられます.
GaN HEMTモデルの選択
これまでに,GaN HEMTデバイス用のコンパクトモデルとして,Angelov GaN-HEMT Model(Angelov),Advanced SPICE Model for HEMTs(ASM-HEMT),MIT Virtual Source GaN HEMT Model(MVSG)の特徴を紹介してきました.
そのデバイス特性,設計環境などによってモデルの選択を行う必要がありますが,モデルをできるだけ多くの用途で使用することを考えた場合,物理的であることは重要といえるでしょう.そのことから,今後はASM-HEMTモデルとMVSGモデルを中心に考察していきたいと思います.
まとめ
今回は,MVSGモデルの概要を仮想ソースモデルのアプローチを交えながら紹介しました.また,実際に3つの違ったプロセス・デバイスの測定値を用いてパラメータ抽出し,ドレイン電流特性をシミュレーションした結果を提示しました.
次回はCMC推奨の物理的なモデル,ASM-HEMTモデルとMVSGモデルの標準的なパラメータ抽出手順を紹介する予定です.
参考文献
[1] U.Radhakrishna, L. Wei, “MIT Virtual Source GaN HEMT: MVSG Model Manual MVSG_CMC Verilog-A model: Version 1.2.0,” Massachusetts Institute of Technology, Dec. 2019.
[2] U.Radhakrishna, D. Piedra, Y. Zhang, T. Palacios, D. Antoniadis “Physics-based Compact Model of High Voltage GaN HEMTs: Experimental Verification, Field Plate Optimization and Charge Trapping,” Electron Devices Meeting (IEDM), IEEE International, Dec. 2013.
[3] Radhakrishna, U., Antoniadis, D. (2014). MIT Virtual Source GaN FET-RF (MVSG-RF) Model. nanoHUB. doi:10.4231/D3G15TC12
(株)モーデックでは,高度なモデル開発,測定,パラメータ抽出システム開発など,モデリングに関する様々なご依頼をお受けいたしております.いつでもお気軽に問い合わせください.

