はじめに
前回はAlGaN/GaN Ridge HEMT(GIT-HEMT)のゲート部分のモデル,特にゲートリーク電流,ゲート容量,しきい値電圧について考察しました.
今回はAlGaN/GaN Ridge HEMT(GIT-HEMT)のドレイン電流モデルを中心に考えてみたいと思います.
ドレイン電流
前回お話しした,しきい値電圧のモデル式はトランジスタ単体のゲートチャネル長・幅の依存が含まれていました.しかし,高い電力を扱うAlGaN/GaN Ridge HEMTは,ゲートフィンガー数(NGF)を増加させて合計のゲート幅を増やし,高電流にして使用します.さらに大きな電流を扱うために,多数ゲートフィンガー数のデバイスを複数接続することで,トランジスタのユニット数(UNIT)を増やして使用します.これらを考慮した場合にしきい値電圧の式は以下のようになります [1].
 (1)
(1)
なお,ここでは温度依存も考慮しています.Tambは環境温度,Tnomは標準的な温度で,Vt_tempは温度係数(パラメータ)になります.
さて,FETのドレイン電流を一般的に表すと,
 (2)
(2)
となります.ここで, でψは任意のチャネル位置での電位になります [2]. 実効移動度の温度依存式 [3]は,
でψは任意のチャネル位置での電位になります [2]. 実効移動度の温度依存式 [3]は,
 (3)
(3)
となり,これはシリコンFETと同様です.ここで,μ0 は低電界移動度を示します.
表面移動度(μs)はドレイン・ソースの表面電位(ψds)に分割されて,その係数(Θsat)を使って表すと,
 (4)
(4)
式(3)に使用されている,ゲート電圧移動度変調効果(UGate)は以下のように表せます.
 (5)
(5)
ここで,UA, UBはモデルパラメータです.同様に式(3)中の,実効チャネル長に依存した移動度変調(Uleff)は,
 (6)
(6)
と表せます.ここで,UP, LPはモデルパラメータになります.
さて,式 (2)についての解法に仮想ソースモデル(Virtual Source Model [2])を適用すると以下のようになります.
 (7)
(7)
 (8)
(8)
 (9)
(9)
 (10)
(10)
 (11)
(11)
 (12)
(12)
ここで,φt は熱電圧. α, SS, δ, δ1, β, θはモデルパラメータです.
ドレイン・ソース抵抗
ドレイン抵抗 (RD)とソース抵抗(RS)共に,ゲート・ドレイン,ゲート・ソース電圧に依存して変化する能動的な抵抗成分と,コンタクト抵抗のような固定部分に分けられます. 固定抵抗は,
 (13)
(13)
で表され,温度に依存しています.また,ゲートフィンガー数とユニット数に反比例します.また,注意すべき点は,等価回路として見た場合ドレイン・ソース抵抗は外部に接続され,非対称になっていることです.シミュレーションの収束性能においては落ちてしまいますが,正確なRF,パワーFETとして正確にシミュレーションされます.
バイアス依存抵抗部分については,外部ノードと内部ノードの間に接続します.固定抵抗分を含んだ式としては以下のようになります.
 (14)
(14)
ここで,RD(S)Wは単位ゲート幅あたりのドレイン(ソース)抵抗になります.PRWGは能動抵抗の係数で,WRE はゲート幅スケーリング係数です.バイアス依存抵抗成分においては,ゲートフィンガー数に依存しますが,ユニット数には依存しない点を注意してください.
ドレイン電流のシミュレーション
これまでに言及したAlN/GaN Ridge HEMTモデルのドレイン電流に関連したモデル式において,自己発熱モデルは,第11回に解説したAlN/GaN MIS-HEMTモデルのものがそのまま使用できます.
以下に測定値とシミュレーション値の比較例を示します.

図1.Ids-Vgs特性の比較(Vdsは4V~40V)
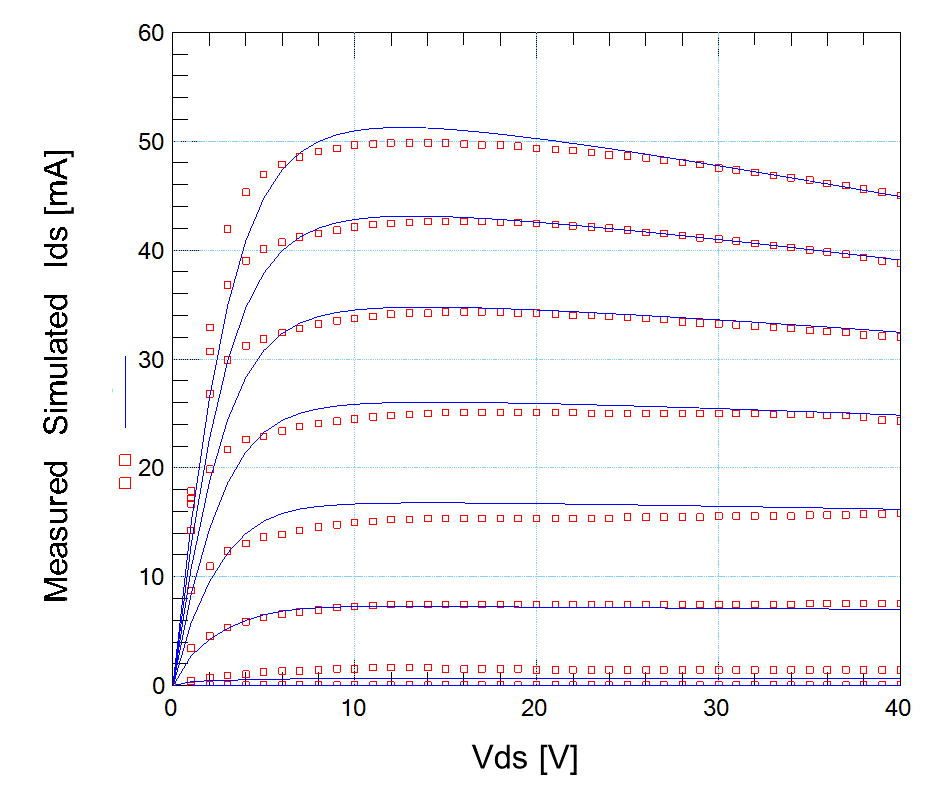
図2.Ids-ds特性の比較(Vgsは1V~5V)
まとめ
今回はAlGaN/GaN Ridge HEMT(GIT-HEMT)のドレイン電流モデルを中心に,ドレイン・ソース抵抗のモデルも考察しました.
次回は,Ridge HEMT特有のホール注入による過剰電流解析とモデル化を言及する予定です.
参考文献
- H. Aoki, N. Kuroda, A. Yamaguchi, and K. Nakahara, “Temperature Characterizations of Multi-Unit and Multi-finger Dependencies on AlGaN/GaN Ridge HEMTs," 2022 IEEE 34th International Conference on Microelectronic Test Structures (ICMTS), (March 2022), Cleveland, OH, USA.
- U. Radhakrishna, L. Wei, D. S. Lee, T. Palacios, D. Antoniadis, “Physics-based GaN HEMT Transport and Charge Model,” IEDM, Dig., pp. 13.6.1-4, Dec. 2012.
- H. Aoki, H. Sakairi, N. Kuroda, A. Yamaguchi, and K. Nakahara, “Drain Current Characteristics of Enhancement Mode GaN HEMTs,” IEEE APEC 2020, Dig. pp.1942-1948, Mar. 2020.
(株)モーデックでは,高度なVerilog-Aを含むコンパクトモデル開発,測定,パラメータ抽出システム開発などの実務以外に,IEEEをはじめとする学会の英文論文誌投稿,国際学会発表のための投稿論文作成のお手伝いなども行っております.
モデリングに関する様々なご依頼をお受けいたしております.いつでもお気軽に問い合わせください.

