はじめに
前回は,MIS-HEMT構造デバイスのモデル化の続きとして,バイアス依存ドレイン・ソース抵抗と自己発熱のモデルを考察しました.
今回はAC特性,特に高周波Sパラメータ特性を対象として,MIS-HEMT構造デバイスの小信号等価回路について考察します.また,信頼性を含めたデバイス特性についても簡単に言及します.
電界効果トランジスタ(FET)の小信号等価回路
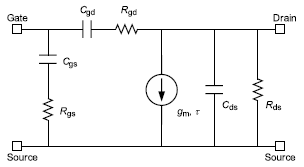
図1.電界効果トランジスタの一般的な小信号等価回路
物理的にも対応しているFET共通のトランジスタ内部小信号モデルを図1に示します.静電容量は、小信号のゲート・ソースおよびゲート・ドレインの静電容量に対応します.電荷発現の測定または微分によって求まり,相互コンダクタンスと出力コンダクタンスは,それぞれ、Vgs と Vdsに関するドレイン電流式の微分になります.ゲート・ソース分岐とゲート-ドレイン分岐の直列抵抗は,ゲート充電電流経路に対応するために含まれています.
トランジスタの遷移周波数は,次のように定義されます.
電流利得が1である周波数,これは図 1の小信号モデルの出力に短絡を適用することで確認できます.帰還容量を無視すると,電流ゲインは次のようになります.
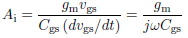 (1)
(1)
正弦波励起の場合に,遷移周波数は,
 (2)
(2)
これは,トランジスタがそのチャネルの電荷を,負荷として動作させた同じサイズの別のトランジスタのゲートに転送できる速度です.HEMTとMOSFETは,ゲート電圧との相互コンダクタンスと入力チャネル容量の関係がMESFETよりも平坦になる傾向があり,広いバイアス範囲で高いftを達成できることを示しています.
発振の最大周波数fmaxは、デバイスから電力を供給できる最大周波数ですが,Yパラメータ変換してトランジスタの一方向利得,U,との関係が以下のように表現できます.
 (3)
(3)
 (4)
(4)
MIS-HEMT構造デバイスの小信号等価回路
ここで対象としている絶縁膜ゲート付きHEMTについて,図1を元に小信号等価回路を組みあげると,図2のようになります[1].
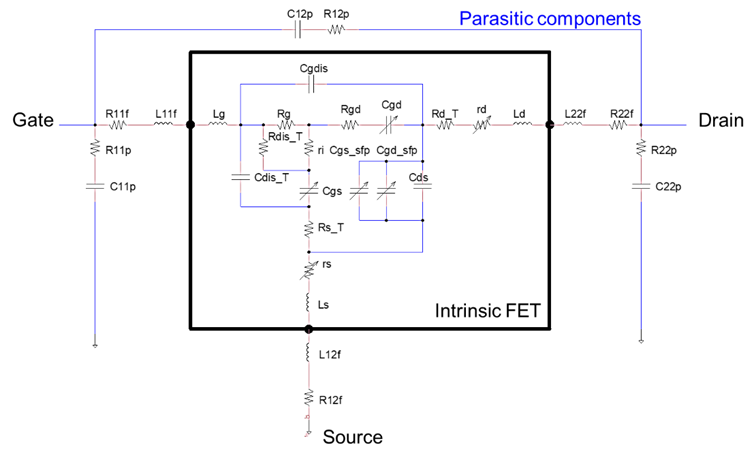
図2.AlGaN/GaN MIS-HEMTの小信号等価回路例
図2の等価回路には,トランジスタ内部(Intrinsic FET)と,各端子のパッドから内部トランジスタの端子に到達するまでの外部寄生成分(Parasitic components)を合わせたものです.外部寄生成分は主に,パッドの抵抗,容量と,伝送ラインのインダクタンスと抵抗から構成されています.
トランジスタ内部等価回路を見てみます.Lg,Ld,Lsは各端子の金属相互接続インダクタンスです.ゲート容量CgsとCgdは,経験的関数式の固定容量(Cgs0とCgd0) [2]とバイアス依存容量にさらに分けられます.Cdsはドレイン・ソース間容量です.Rdis_T,Cdis_T,Cgdisは,それぞれ入力と出力の分散抵抗と静電容量です.riはゲートからソースへの内部抵抗(チャージ抵抗)です.Rg,Rd_T,Rs_Tは,それぞれゲート,ドレイン,ソースの抵抗です.Rgdはゲートからドレインへの抵抗です.ソース・フィールドプレート(SFP)はドレインとグランドの間に接続されたMOSFETのように形成されるため [3],スケーラブルなゲート容量(Cgs_sfpとCgd_sfp)はCdsと並列になります。SFPはMISFETとして動作するため,SFPトランジスタのモデル式はメインのMISFETと同じになります.SFPトランジスタで使用されるプロセスおよびモデルパラメータは,スケーリングされたデバイスの測定データから抽出されます.
AlGaN/GaN MIS-HEMTのデバイス特性 [4]
MIS構造のHEMTはゲートもれ電流が小さく,電圧駆動のため低消費電力です.通常のショットキーゲート型のHEMTでは,ゲート電極と半導体で決まるショットキー障壁の高さ制限により,ゲート電圧は1.5V程度しか印加できませんが,ゲートもれ電流が抑えられた結果10V近くまで印加できます.
一方でしきい値電圧が低く,ゲート界面の信頼性が低いという欠点があります.ゲート絶縁膜を形成する際に接触面が均一でないと,多くのエネルギー順位が存在してしまい,電流・電圧特性においても条件により不安定な動作となる可能性があります.
MIS-HEMT構造デバイスと相反する特徴を持つエンハンスメント型HEMTに,Ridge HEMT(GIT-HEMT)があります.つまり,高いしきい値電圧と高い電子移動度を特長としています.一方で,ゲートリーク電流が高く,ゲートスイッチング速度が遅いという弱点があります.
まとめ
今回はMIS-HEMT構造デバイスの小信号等価回路とMIS-HEMTデバイス特性について言及しました.次回からはMIS-HEMT構造デバイスに相反する特徴を持った,AlGaN/GaN Ridge HEMT(GIT-HEMT)の特徴とモデリングについて考えてみようと思います.
参考文献
- H. Aoki, H. Sakairi, N. Kuroda, Y. Nakamura, K. Chikamatsu, and K. Nakahara, “A Small Signal AC Model Using Scalable Drain Current Equations of AlGaN/GaN MIS Enhancement HEMT,” 2018 Radio Frequency Integrated Circuit Symposium (RFIC2018) at International Microwave Symposium, Philadelphia, PA, U.S.A.
- I. Angelov, H. Zirath, N. Rorsmann, "A New Empirical Nonlinear Model for HEMT and MESFET Devices," IEEE MTT Vol. 40, No. 12, December 1992.
- H. Aoki, N. Tsukiji, H. Sakairi, K. Chikamatsu, N. Kuroda, S. Shibuya, K. Kurihara, M.Higashino, H. Kobayashi, and K. Nakahara, “Electron Mobility and Self-Heat Modeling of AlN/GaN MIS-HEMTs with Embedded Source Field-Plate Structures,” 2016 IEEE Compound Semiconductor IC Symposium, Oct. 23-26, 2016, Austin, Texas, U.S.A.
- H. Aoki, H. Sakairi, N. Kuroda, A. Yamaguchi, and K. Nakahara, “Drain Current Characteristics of Enhancement Mode GaN HEMTs,” 2020 35th Annual IEEE Applied Power Electronics Conference & Exposition (APEC 2020), (March 15-19, Online), New Orleans, Louisiana, U.S.A.
(株)モーデックでは,高度なVerilog-Aを含むコンパクトモデル開発,測定,パラメータ抽出システム開発などの実務以外に,IEEEをはじめとする学会の英文論文誌投稿,国際学会発表のための投稿論文作成のお手伝いなども行っております.モデリングに関する様々なご依頼をお受けいたしております.いつでもお気軽に問い合わせください.

