サービスの概要
SPICEで信頼性シミュレーションを行うために必要なサービスをご提供いたします。
- MOSFETのホットキャリア(Hot Carrier Injection、HCI)による特性劣化シミュレーション用SPICEモデリング
- MOSFETのBTI(Bias Temperature Instability)による特性劣化シミュレーション用SPICEモデリング
- 特性劣化シミュレーション用SPICEモデリングを行うための測定条件決定支援
こんなことでお困りではありませんか?
- 製品寿命とレイアウトサイズのバランスが取れた最適化設計を行いたい
- 回路設計の段階で製品寿命の予測を行いたい
- 新規プロセス導入時に製品寿命の見積をしたい
- 顧客から半導体製品の信頼性設計に関するエビデンスを求められた
トランジスタの劣化と製品寿命
現在あらゆる半導体製品で用いられているMOSトランジスタは、動作中に特性が劣化することが広く知られています。そのメカニズムは大きく分けて、HCI(Hot Carrier Injection)とBTI(Bias Temperature Instability)の2つがあります。HCIは主にNMOSで問題となり、DAHC(Drain Avalanche Hot Carrier)やCHC(Channel Hot Carrier)などがあります。BTIはNMOSではPBTI(Positive Bias Temperature Instability)、PMOSではNBTI(Negative Bias Temperature Instability)と呼ばれています。HCI、BTIどちらも動作時間の経過とともに、VT増加やID減少、Gm劣化などが起こり、製品動作に重大な影響を及ぼし、最終的には動作不良が起こります。また、この特性劣化はトランジスタに印加される電圧値や電流値により劣化の度合いが変わってしまいます。
そのため、HCIやBTIによる特性劣化を考える場合、本来は回路内で使っている個々のトランジスタ全てを考慮しなければならないのですが、それを行う手法は確立されておらず、設計者の経験やオーバースペックな製品設計などを行うことで対策をとる事例が多く、半導体製品の製品寿命を正確に知るには不十分でした。

SPICEによる信頼性シミュレーション
SPICEで通常の電気特性シミュレーションを行う場合、1種類のトランジスタについて1個のSPICEモデルが用意されており、そのモデルを用いてシミュレーションを行います。例えば、CMOSで設計した回路のシミュレーションを行う場合、NMOSとPMOSの2個のSPICEモデルを使用します。しかし、信頼性シミュレーションを行う場合、初期シミュレーションでは電気特性シミュレーションと同じですが、最終的には回路に使用されている全てのMOSトランジスタに対して個別のモデルが設定されます。すなわち、回路の中に100個のMOSトランジスタがある場合、100個のSPICEモデルを用いてシミュレーションを行い、特性劣化をシミュレーションします。
このように、SPICEで信頼性シミュレーションを行えば、回路中の全てのMOSトランジスタの劣化具合を把握することができます。また、動作途中に回路内のバイアス状態が変わり、製品寿命に重大な影響を及ぼすクリティカル素子が変わったとしてもそれに追随することが可能であり、より正確な製品寿命予測を行うことが可能です。
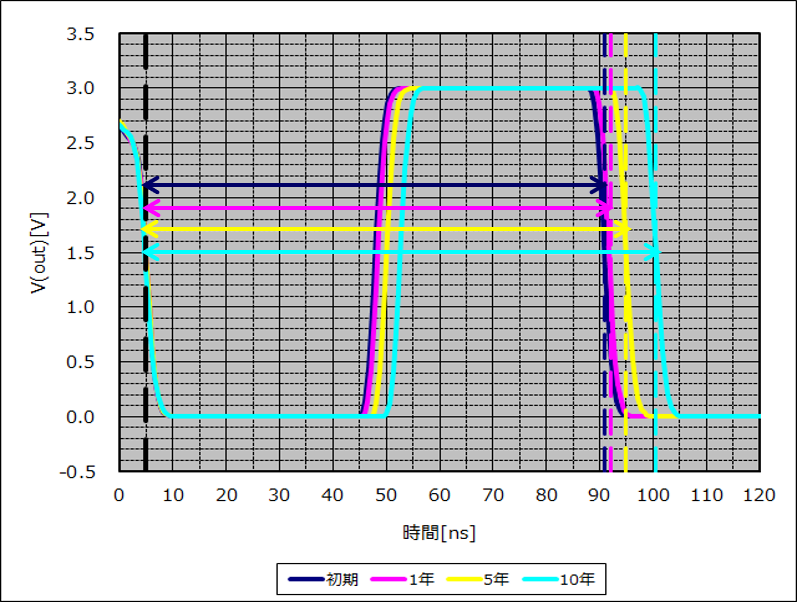 Ring Oscillator の発振波形の劣化シミュレーション
Ring Oscillator の発振波形の劣化シミュレーション  ディバイダ回路の劣化シミュレーション
ディバイダ回路の劣化シミュレーション 対応デバイス、モデル、シミュレータ
- CMOS
- HVMOS
- LDMOS
- VDMOS
- AgeMOS
- DAHC
- CHC
- NBTI
- PBTI
※任意モデル組込も検討します。詳細は問い合わせてください。
コンパクトモデル
- BSIM3
- BSIM4
- HiSIM-HV
※その他各種モデル。詳細は問い合わせてください。
- Spectre®
- Eldo®
